
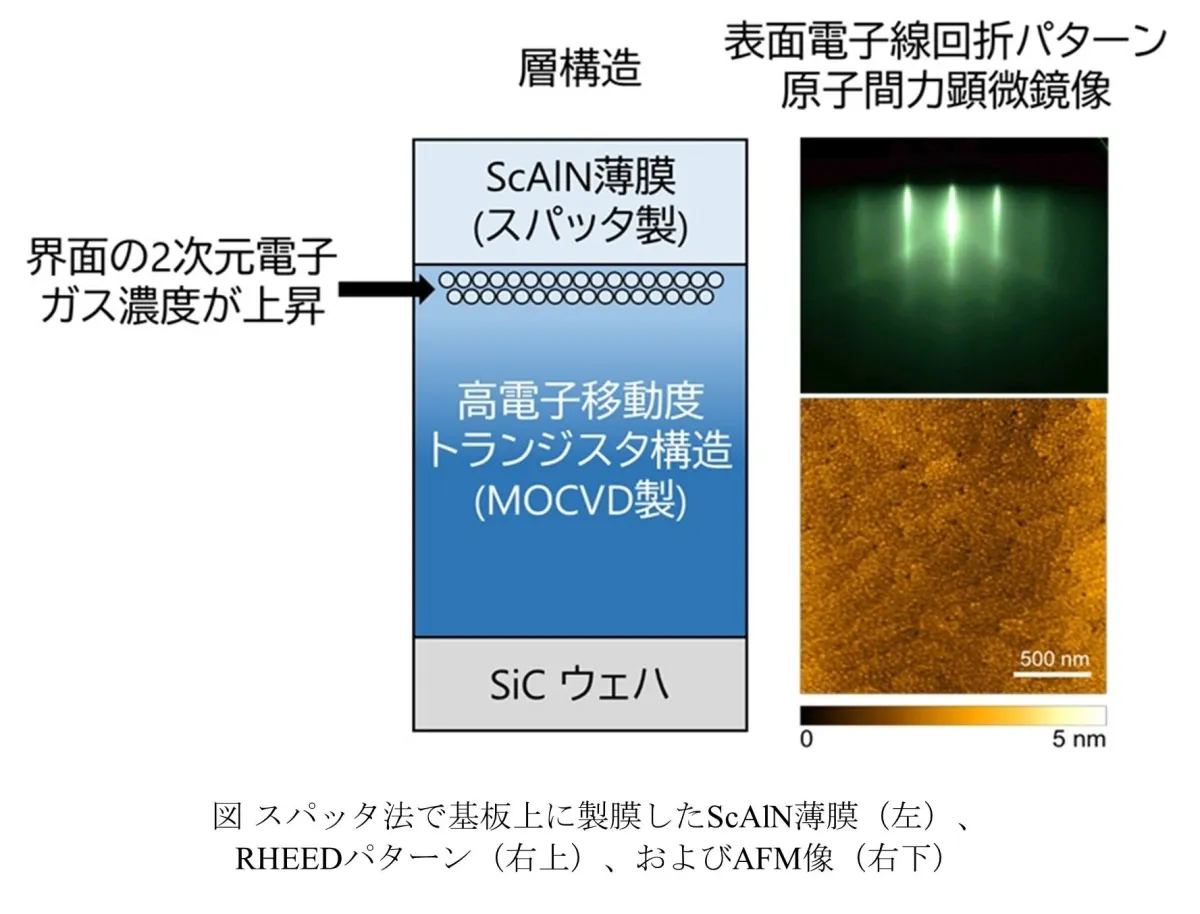
スパッタ法で高品質ScAlN薄膜を生成、電気特性が大幅向上
スパッタ法による高品質なScAlN薄膜の生成
東京理科大学の先進工学部に所属する研究グループが、スパッタ法を利用して難易度の高い窒化スカンジウムアルミニウム(ScAlN)薄膜を高品質に作製することに成功しました。この研究は、次世代の高性能電子デバイスの材料開発に向けた大きな一歩となるものです。
研究の背景と目的
GaN系の窒化物半導体は、広いバンドギャップや高電圧耐性、大きな分極効果といった優れた特性から、高出力・高周波デバイスに利用されています。その中で、ScAlNは特に注目されており、高電子移動度トランジスタ(HEMT)のバリア材料として期待されています。従来、ScAlN薄膜は複雑な成長プロセスと高コストが課題でしたが、スパッタ法の採用によりこれらのハードルを克服する可能性が示されました。
成長温度と薄膜の特性
本研究グループは、AlGaN/AlN/GaN/SiC基板上に、250℃から750℃の範囲で成長させたScAlN膜を評価しました。実験の結果、成長温度が750℃のときに薄膜の平坦性と質が最高であることが示され、特にこの条件下では2次元電子ガス密度が約3倍に増加しました。これは、750℃で得られたステップフロー成長により、原子レベルでの界面平坦化が実現され、より高いキャリア密度を得ることができたためです。
電気特性の向上
750℃で成長された薄膜では、シートキャリア密度が1.1×10^13 cm^-2と、スパッタ前の3倍という結果が得られました。一方で、電子移動度は全体的に低下しており、これは主に界面付近の負電荷によるものであることがシミュレーション解析から明らかになっています。これらの結果は、成長条件が薄膜の特性にどのように影響を与えるかを理解する上で重要な知見となります。
今後の展望
この研究成果は、次世代エレクトロニクス材料の開発における重要な手掛かりとなります。スパッタ法による高品質ScAlN薄膜の生成が実現したことにより、環境に優しい高性能電子デバイスの実用化が一層期待されます。さらに、今回の研究成果は国際的な学術誌「APL Materials」にも掲載され、注目を集めています。
今後の課題としては、電子移動度の低下を克服することが挙げられます。研究グループは引き続き検討を進めながら、より高度なエレクトロニクス技術の開発へと繋げていく方針です。
研究を支える背景
このプロジェクトは、日本学術振興会やさまざまな財団の助成を受けて進められました。研究リーダーである小林准教授は、「ScAlN薄膜の成長には難しさが伴っていたが、この成果によって高性能な電子デバイスが普及し、産業界に貢献できることを期待しています」と述べています。
本研究の詳細については東京理科大学の公式発表をご覧ください。
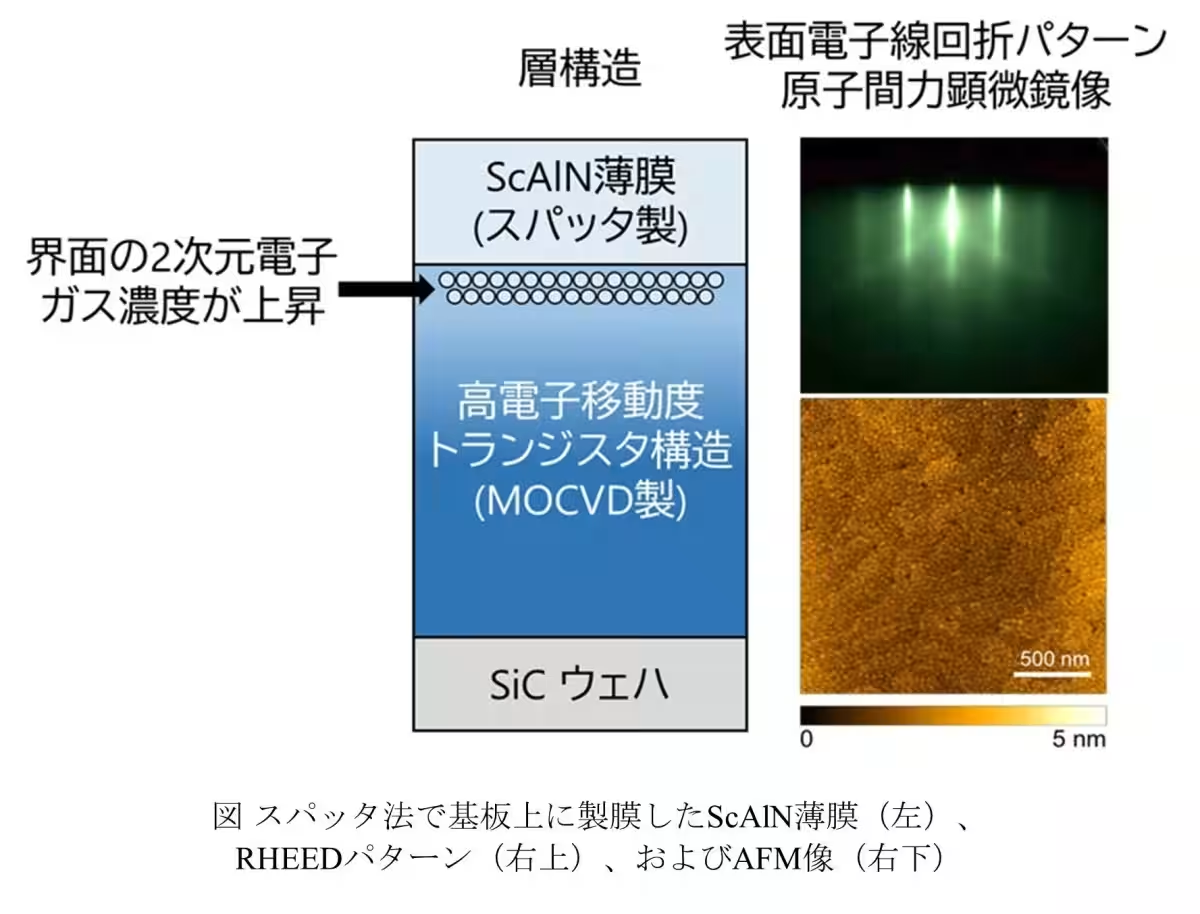
トピックス(その他)










【記事の利用について】
タイトルと記事文章は、記事のあるページにリンクを張っていただければ、無料で利用できます。
※画像は、利用できませんのでご注意ください。
【リンクついて】
リンクフリーです。