
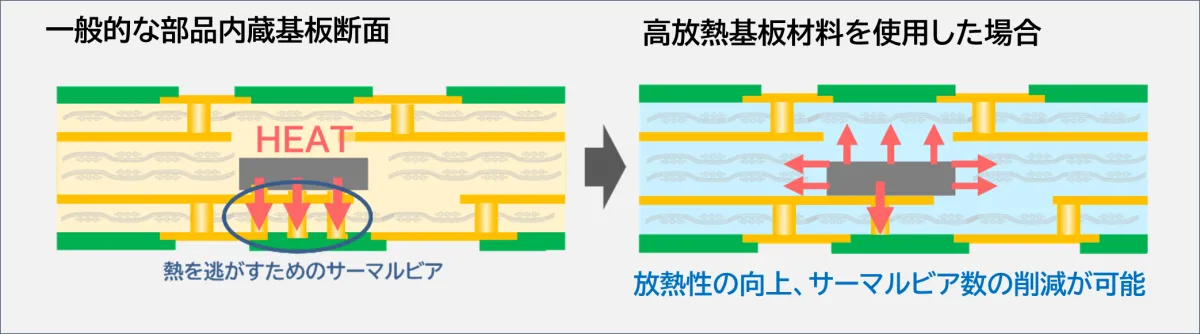
住友ベークライトが発表した高放熱基板材料LαZ®のサンプル出荷開始
住友ベークライトが高熱伝導基板材料LαZ®のサンプル出荷を開始
東京都品川区を本社とする住友ベークライト株式会社が、半導体パッケージ用の新製品LαZ®を発表しました。この高熱伝導基板材料は、半導体チップから発生する熱を効率的に放散し、パッケージの性能向上に寄与することを目指しています。
背景
近年、AI、5G、エッジコンピューティングの普及により、高周波化や出力容量の増加が求められています。これに伴い、半導体チップは高集積化・小型化が進められていますが、内部の発熱が製品に及ぼす影響が大きな課題となっています。発熱を抑制することにより、エネルギー効率や性能を高めるための技術が求められています。
内蔵チップの放熱対策
従来、内蔵された半導体チップの熱を放散するためには、サーマルビアと呼ばれる導電性ビアを用いる方法が主流でした。しかし、基板自体に高い熱伝導性を持たせることで、放熱性が向上し、ビアの数を減少させることができます。これにより、回路設計における自由度が増し、部品の小型化にも寄与すると期待されています。
LαZ®の特長
新たに開発されたLαZ®は、プリプレグタイプで1.5W、レジンフィルムタイプで2.1Wという高い熱伝導率を誇ります。特にレジンフィルムタイプには、チップ埋込用のキャビティを高流動性樹脂で埋め込む技術が搭載されており、基板内部の放熱性を大きく向上させることが可能です。
メリット
1. 放熱性の向上
新素材を使用することで、半導体チップの発熱を効果的に拡散させることができます。特に、チップや部品を内蔵した基板においては、放熱効果が一層期待されます。
2. パッケージの小型化
基板の熱伝導率を高めることで、チップをより密に内蔵することができ、パッケージの小型化が実現します。
3. 設計の自由度向上
高熱伝導基板材料の採用により、サーマルビアの数が減ることで、複雑で高性能な回路設計が可能になります。
今後の展望
住友ベークライトは、2025年度中にLαZ®の量産化を目指しています。また、この技術を応用してコア材へのラインアップ拡充も計画しています。同社は今後も市場や顧客のニーズに応じたパッケージ材料の開発を続け、半導体の高機能化や生産性向上に貢献していく方針です。
本商品に関するお問い合わせは、住友ベークライト株式会社 情報通信材料営業本部までお電話でどうぞ。
連絡先: TEL: 03-5462-4015
お問い合わせフォームはこちらからアクセスできます。
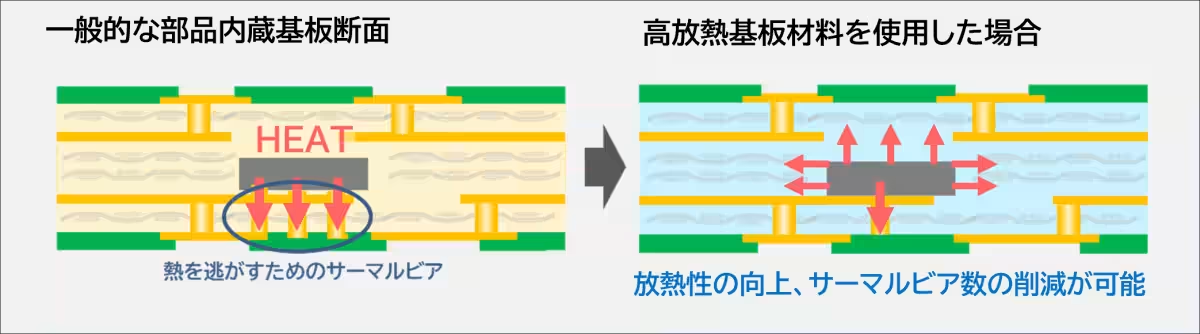
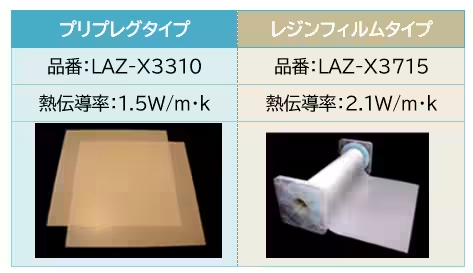
トピックス(その他)










【記事の利用について】
タイトルと記事文章は、記事のあるページにリンクを張っていただければ、無料で利用できます。
※画像は、利用できませんのでご注意ください。
【リンクついて】
リンクフリーです。